什么是氮化镓(GAN)
氮化镓,由镓(原子序数 31)和氮(原子序数 7)结合而来的化合物。它是拥有稳定六边形晶体结构的宽禁带半导体材料。禁带,是指电子从原子核轨道上脱离所需要的能量,氮化镓的禁带宽度为 3.4eV,是硅的 3 倍多,所以说氮化镓拥有宽禁带特性(WBG)。

GAN材料特性
与Si相比,GAN具有禁带宽度大、高击穿场强、高电子迁移率、高电子饱和漂移速度的特点

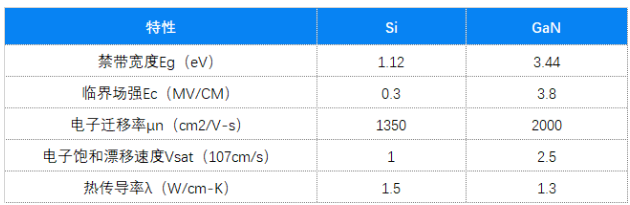
禁带宽度:半导体的禁带宽度与晶格原子之间的化学键强度有关,更强的化学键意味电子更难从一个位置跳跃到下一个位置,所以较大的禁带宽度的半导体材料具有较低的本征泄漏电流和较高的工作温度
临界场强:更强的化学键导致更大的禁带宽度,也导致引起雪崩击穿时更高的临界击穿电场
电子迁移率: GaN的击穿场强是Si的10倍,电子迁移率约为Si的1.5倍,可以有效减小导通电阻Rdson。换言之,对于相同的导通电阻Rdson,GaN的芯片面积更小,有利于减小器件的寄生参数。
电子饱和漂移速度:电子饱和漂移速度代表电子整体漂移速度随电场增加能够达到的上限,对器件的工作频率有重要影响。GaN的电子饱和漂移速度是Si的2.5倍,可以显著提升器件的工作频率。
GAN晶体管的基本结构
从结构上讲,GAN器件以横向结构为主,从下到上分为衬底(substrate)、缓冲层(buffer)、GaN外延层(epitaxy)与AlGaN势垒层(barrier)。AlGaN势垒层与GaN外延层的界面处发生极化效应,在GaN内形成一层电子,称为二维电子气(2DEG)。2DEG作为天然的导电沟道, 使得GaN HEMT保持常开,属于耗尽型(D-Mode)器件。

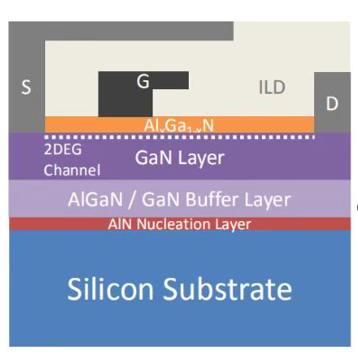
在电力电子变换器中使用D-Mode器件时,需要在G、S之间加负压关断器件,这会增加驱动电路的复杂性,也带来器件直通的隐患。为应对这个问题,业界通常有两种解决方案,一是采用级联(cascode)结构,二是采用在门极增加P型氮化镓从而形成增强型(常闭)晶体管,如下图所示,级联常关器件为增强型SI FET和耗尽型GAN串联,门级驱动直接接到低压MOS而不是GAN,目前主流的技术是使用P-GaN的工艺结构增强型晶体管,在GaN 的栅极下方放置了PGaN层。PGaN使栅极下方的GaN外延层形成耗尽区,阻断了2DEG。随着Vgs的电压逐渐加大,栅极下方的2DEG逐渐恢复,沟道能够导通的电流Ids也越大。当Ids达到指定值时,对应的Vgs称为阈值电压Vth。

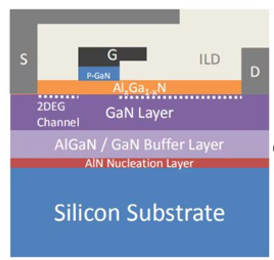
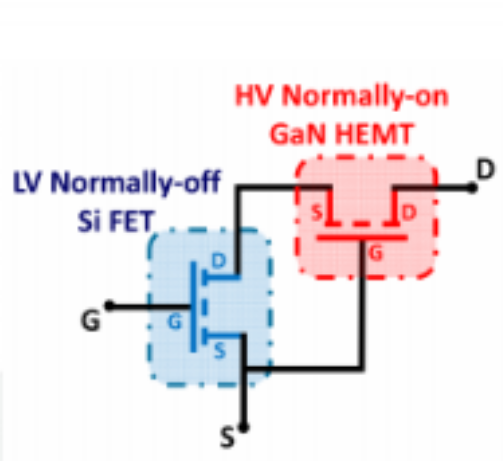
GaN晶体管电气特性
材料特性和器件结构的差异导致GaN与Si MOSFET在电气特性方面有所区别,以下为GAN与SI对比数据


1):耐压特性
雷击,启机或负载切换等偶发事件可能引起器件的Vds过压,实际测试中,GaN可承受比SI更高的电压。


2):开关速度
开关速度主要受Ciss(Ciss=Cgs+Cgd)影响。Ciss越大, Vgs的变化速度越慢,开关速度也越慢。类似规格的GaN与Si MOSFET对比,其Ciss小于Si MOSFET的1/10。减小结电容有利于提高开关速度,降低损耗以及高频化工作。经测试,GaN的导通速度明显更快,有效缩短了Vds与Id的交叠时间,从而降低开关损耗。器件高频化工作可以有效减小电路中电感、变压器以及电容的尺寸,显著提高功率密度。

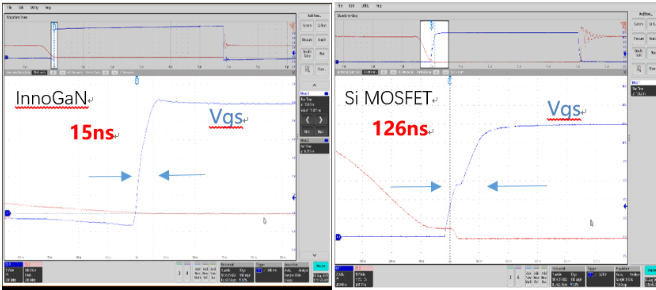
3):驱动特性
GaN HEMT 的驱动电平与Si MOSFET存在差异。产品规格书规定了Vgs的电平范围,保证栅极不被损坏。此外,Vgs决定器件沟道开通程度。由输出特性曲线可见,Vgs越大,沟道开通越充分,器件的通流能力越强。

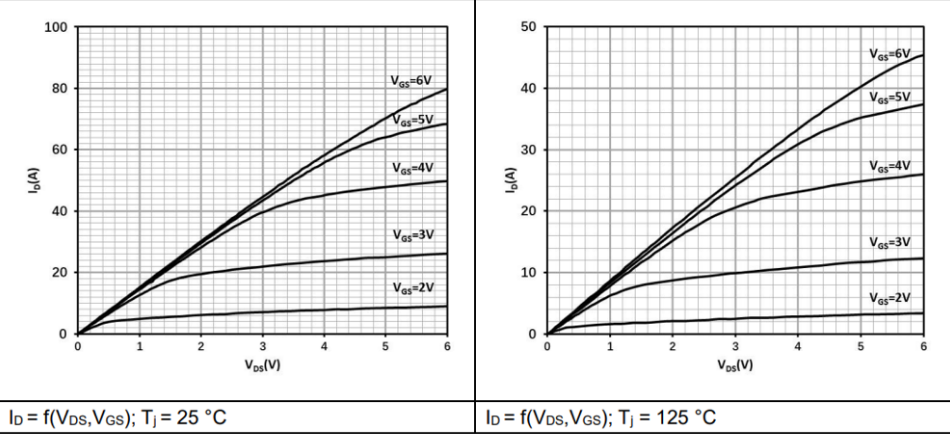
4):反向特性
Si MOSFET依靠体二极管实现反向导通。二极管在正向导通到反向截止的过程中,由于电荷储存效应,会流过反向电流,称为二极管的反向恢复。这个过程会带来额外的损耗和噪声,妨碍电路的效率提升和EMI设计。GaN HEMT不存在体二极管,依靠自身沟道实现反向导通,因此避免了反向恢复带来的问题。